„Sputtern“ – Versionsunterschied
| [gesichtete Version] | [gesichtete Version] |
Ergänzungen |
|||
| Zeile 1: | Zeile 1: | ||
Das '''Sputtern''' (aus dem Englischen {{lang|en|''to sputter''}} = zerstäuben) – oder auf deutsch, die '''Kathodenzerstäubung''' – ist ein physikalischer Vorgang, bei dem Atome aus einem Festkörper ([[Target (Physik)|Target]]) durch Beschuss mit energiereichen Ionen (vorwiegend Edelgasionen) herausgelöst werden und in die Gasphase übergehen. |
Das '''Sputtern''' (aus dem Englischen {{lang|en|''to sputter''}} = zerstäuben) – oder auf deutsch, die '''Kathodenzerstäubung''' – ist ein physikalischer Vorgang, bei dem Atome aus einem Festkörper ([[Target (Physik)|Target]]) durch Beschuss mit energiereichen Ionen (vorwiegend Edelgasionen) herausgelöst werden und in die Gasphase übergehen. |
||
Angewendet wird dieser Effekt beispielsweise in der [[Oberflächenphysik]] als Reinigungsverfahren zur Präparation hochreiner Oberflächen, als Verfahren zur Analyse der chemischen Zusammensetzung von Oberflächen (z. B. [[Sekundärionen-Massenspektrometrie|SIMS]], [[Sekundär-Neutralteilchen-Massenspektrometrie|SNMS]]) oder als [[Sputter-Ionenquelle]] für [[Teilchenbeschleuniger]] zum Einsatz. Große technische Bedeutung hat das Verfahren als Teilschritt bei der Sputterdeposition, einer zur Gruppe der [[Physikalische Gasphasenabscheidung|PVD-Verfahren]] gehörenden [[Vakuum|hochvakuumbasierte]] Beschichtungstechnik. Hier dient es zum Zerstäuben eines Materials, dass sich anschließend auf einem Substrat niederschlägt und eine feste Schicht bildet. Im Bereich der beschichtungstechnik wird die Sputterdeposition häufig nur als „Sputtern“ bezeichnet. |
|||
Unter dem Begriff ''Sputtern'' wird meistens nur die Sputterdeposition, eine zur Gruppe der [[Physikalische Gasphasenabscheidung|PVD-Verfahren]] gehörende [[Vakuum|hochvakuumbasierte]] Beschichtungstechnik, verstanden. Weiterhin kommt das Sputtern in der [[Oberflächenphysik]] als Reinigungsverfahren zur Präparation hochreiner Oberflächen, als Verfahren zur Analyse der chemischen Zusammensetzung von Oberflächen und als [[Sputter-Ionenquelle]] für [[Teilchenbeschleuniger]] zum Einsatz. |
|||
In Elektronenröhren und Gasentladungsröhren wie [[Glimmlampe]]n und [[Nixie-Röhre]]n gehört Sputtern zu den unerwünschten, Lebensdauer-begrenzenden Effekten. Durch das Auftreffen von Ionen auf die Elektroden werden diese in Mitleidenschaft gezogen. Zudem schlägt sich das abgetragene Elektrodenmaterial an der Innenseite des Glaskolbens ab, was dessen Transparenz vermindert. |
In Elektronenröhren und Gasentladungsröhren wie [[Glimmlampe]]n und [[Nixie-Röhre]]n gehört Sputtern zu den unerwünschten, Lebensdauer-begrenzenden Effekten. Durch das Auftreffen von Ionen auf die Elektroden werden diese in Mitleidenschaft gezogen. Zudem schlägt sich das abgetragene Elektrodenmaterial an der Innenseite des Glaskolbens ab, was dessen Transparenz vermindert. |
||
| ⚫ | |||
== Grundlagen des Sputterprozesses == |
== Grundlagen des Sputterprozesses == |
||
| Zeile 20: | Zeile 18: | ||
Der Ionenbeschuss erzeugt nicht nur neutrale Atome, sondern auch [[Sekundärelektron]]en sowie in geringerem Umfang Sekundärionen und Cluster verschiedener Masse ([[Sekundärionen-Massenspektrometrie]]). Die Energieverteilung der gelösten Atome hat ein Maximum bei der halben Oberflächenbindungsenergie bei einigen eV, fällt aber zu hohen Energien nur langsam ab, so dass die mittlere Energie häufig eine [[Größenordnung]] darüber liegt. Ausgenutzt wird dieser Effekt in Analysemethoden der [[Oberflächenphysik]] und [[Dünnschichttechnologie]] sowie zur Herstellung dünner Schichten (Sputter[[deposition]]). |
Der Ionenbeschuss erzeugt nicht nur neutrale Atome, sondern auch [[Sekundärelektron]]en sowie in geringerem Umfang Sekundärionen und Cluster verschiedener Masse ([[Sekundärionen-Massenspektrometrie]]). Die Energieverteilung der gelösten Atome hat ein Maximum bei der halben Oberflächenbindungsenergie bei einigen eV, fällt aber zu hohen Energien nur langsam ab, so dass die mittlere Energie häufig eine [[Größenordnung]] darüber liegt. Ausgenutzt wird dieser Effekt in Analysemethoden der [[Oberflächenphysik]] und [[Dünnschichttechnologie]] sowie zur Herstellung dünner Schichten (Sputter[[deposition]]). |
||
Wird eine atomar dünne Schicht durch Sputtern abgetragen, so kann die Anzahl der nach der Zeit t gesputterten Teilchen nach folgender Gleichung abgeschätzt werden: |
Wird eine atomar dünne Schicht durch Sputtern abgetragen, so kann die Anzahl der nach der Zeit <math>t</math> gesputterten Teilchen nach folgender Gleichung abgeschätzt werden: |
||
:<math> N(t) = N_\ |
:<math> N(t) = N_\text{max}\left(1- \exp\left(-\frac{Y I_\text{P}}{e N_\text{max}}\, t\right)\right)</math> |
||
mit e: [[Elementarladung]], <math>N_{max}</math>: Anzahl Teilchen auf der Oberfläche (ca. 10<sup>15</sup> cm<sup>−2</sup>), Y: [[Sputterausbeute]] (Anzahl der gesputterten Teilchen pro auftreffendes Teilchen), <math> |
mit e: [[Elementarladung]], <math>N_\text{max}</math>: Anzahl Teilchen auf der Oberfläche (ca. 10<sup>15</sup> cm<sup>−2</sup>), Y: [[Sputterausbeute]] (Anzahl der gesputterten Teilchen pro auftreffendes Teilchen), <math>I_\text{P}</math>: Primärstrom. |
||
== Sputterdeposition == |
== Sputterdeposition == |
||
| ⚫ | |||
=== Allgemeines === |
=== Allgemeines === |
||
Bei der Sputterdeposition wird in die Nähe des Targets ein Substrat gebracht, so dass die herausgeschlagenen Atome auf diesem [[kondensieren]] und eine Schicht bilden können. Dabei muss in der Prozesskammer ein ausreichend geringer [[Gasdruck]] vorhanden sein (ein [[Vakuum]]), dass die Targetatome das Substrat erreichen ohne mit noch vorhandenen Gasteilchen |
Bei der Sputterdeposition, auch Sputterbeschichtung genannt, wird in die Nähe des Targets ein Substrat gebracht, so dass die herausgeschlagenen Atome auf diesem [[kondensieren]] und eine Schicht bilden können. Dabei muss in der Prozesskammer ein ausreichend geringer [[Gasdruck]] vorhanden sein (ein [[Vakuum]]), dass die Targetatome das Substrat erreichen ohne mit noch vorhandenen Gasteilchen zusammen zustoßen. Das heißt, die [[mittlere freie Weglänge]] der Gasteilchen muss mindestens dem Abstand des Targets zum Substrat entsprechen. Bei einem Abstand von ca. 30 cm sollte der Gasdruck daher nicht größer als ca. 2×10<sup>−4</sup> mbar ([[Hochvakuum]]) betragen, andernfalls sind schlechtere Schichteigenschaften die Folge. |
||
Aufgrund seiner großen technischen Bedeutung wird mit dem Begriff „Sputtern“ häufig auch dieses Depositionsverfahren bezeichnet. |
|||
<!--=== Beispiele ===--> |
<!--=== Beispiele ===--> |
||
| Zeile 39: | Zeile 37: | ||
=== Varianten === |
=== Varianten === |
||
Die Sputterdeposition zählt seit Jahrzehnten zu den wichtigsten Beschichtungsverfahren. In dieser Zeit wurden unterschiedliche Varianten entwickelt, mit denen sich die Schichteigenschaften gezielt beeinflussen oder die Bandbreite der abscheidbaren Materialien erhöhen lassen. Nachfolgend werden die wichtigsten Grundformen kurz beschrieben. Dabei ist zu beachten, dass von allen Varianten zusätzlich Mischformen existieren, z. B. dem HF-Magnetronsputtern eine Mischung aus dem Hochfrequenz- und dem Magnetronsputtern. |
|||
Von allen nachfolgenden Varianten existieren zusätzlich Mischformen, z. B. RF-Magnetron-Sputtern. |
|||
Die wichtigsten Grundformen sind: |
|||
| ⚫ | |||
| ⚫ | |||
Mit einer Beschleunigungsgleichspannung ''U''<sub>B</sub> von 500 bis 1000 V wird ein Argon-[[Niederdruckplasma]] zwischen einem Target und einem Substrat gezündet. Positive Argonionen schlagen aus dem Target Atome heraus (Sputterprozess), die dann zum Substrat wandern und dort kondensieren (Sputterdeposition). |
|||
# HF-Sputtern |
|||
# Ionenstrahlsputtern |
|||
# Magnetronsputtern |
|||
# Reaktives Sputtern |
|||
| ⚫ | |||
Wesentlicher Nachteil dieses Verfahrens ist es, dass sich nur elektrische leitfähige Materialien (wie Metalle) nutzen lassen, da sich sonst ein Gegenfeld aufbaut und der Sputterprozess stoppt. Des Weiteren werden nur geringe Sputterraten erreicht, da nur wenige Argonionen entstehen. |
|||
Beim DC-Sputtern wird zwischen Target und dem zu beschichtenden Substrat eine Gleichspannung von einigen hundert Volt angelegt, es wird daher auch Gleichspannungssputtern genannt. Das Target bildet hierbei die negative und das Substrat die positiv geladene Elektrode. Durch Stoßionisation der Atome des eingesetzten Inertgases (z. B. [[Argon]]) bildet sich im Gasraum ein [[Plasma]] (ein Argon-[[Niederdruckplasma]]), dessen Bestandteile negativ geladene Elektronen und positiv geladene Gasionen, wie Ar<sup>+</sup>, durch die angelegte Gleichspannung in Richtung des Substrats bzw. des Targets beschleunigt werden. Es trifft nun ein dauerhafter Strom aus positiven Ionen auf das Target; daher auch der englischsprachige Name des Verfahrens {{lang|en|direct current sputtering}}, dt. Gleichstrom- bzw. DC-Sputtern. Beim Aufprall auf das Target werden durch Impulsübertrag Teilchen aus dem Target herausgeschlagen, die sich nun weg vom Target in Richtung des Substrates bewegen und sich dort als dünne Schicht niederschlagen (Deposition). |
|||
| ⚫ | |||
Das Target wird als dritte Elektrode außerhalb des Plasmaraums angeordnet. Plasmaerzeugung und Sputterprozess werden damit entkoppelt. |
|||
Wesentlicher Nachteil dieses Verfahrens ist, dass diese Variante nur für mit elektrisch leitfähigen Targetmaterialien anwendbar ist. Elektrisch isolierende Materialien würden sich durch die ständig Versorgung mit neuen Ladungsträgern aufladen, damit das Gleichspannungfeld kompensieren und den Sputterprozess behindern. Ähnlich verhält es sich mit dem Substrat, dass sich durch die auftreffenden energiereichen Elektronen nicht nur aufladen könnte sondern sich auch einer hohe Wärmebelastung ausgesetzt ist. |
|||
| ⚫ | |||
Darüber hinaus sind die erreichbaren Sputterraten und damit auch die Beschichtungsraten relativ gering, da in dem eingesetzten Niederdruckplasma nur wenige Argonionen entstehen. |
|||
| ⚫ | Beim Hochfrequenzsputtern (kurz HF-Sputtern, engl. {{lang|en|''radio frequency sputtering''}}, {{lang|en|''RF sputtering''}}) wird statt des elektrischen Gleichfeldes ein hochfrequentes Wechselfeld angelegt. Die dafür notwendige Hochfrequenzspannungsquelle wird in Reihe mit einem [[kondensator (Elektrotechnik)|Kondensator]] und dem Plasma geschaltet. Der Kondensator dient dazu, den Gleichspannungsanteil abzutrennen und das Plasma elektrisch neutral zu halten. |
||
{{Überarbeiten}} |
|||
| ⚫ | |||
Die zuvor beschriebene Variante mit zwei Elektroden wird auch als DC-Dioden-Sputtern bezeichnet. Darüberhinaus existieren noch weitere Formen wie das DC-Trioden-Sputtern, bei dem das Target als dritte Elektrode außerhalb des Plasmaraums angeordnet wird. Auf diese Weise kann die Plasmaerzeugung und der Sputterprozess entkoppelt werden. |
|||
| ⚫ | |||
| ⚫ | Die Elektronen oszillieren im Gebiet des Plasmas und es kommt vermehrt zu Stößen mit Argonatomen. Dies bewirkt eine hohe Plasmarate, eine Folge davon ist die mögliche Drucksenkung auf 1–20 m[[Torr]] (etwa 10<sup>−1</sup> |
||
| ⚫ | Beim Hochfrequenzsputtern (kurz HF-Sputtern, engl. {{lang|en|''radio frequency sputtering''}}, {{lang|en|''RF sputtering''}}) wird statt des elektrischen Gleichfeldes ein hochfrequentes Wechselfeld angelegt (meist mit der freie Funkfrequenz von 13,56 MHz oder Vielfachen davon). Die dafür notwendige Hochfrequenzspannungsquelle wird in Reihe mit einem [[kondensator (Elektrotechnik)|Kondensator]] und dem Plasma geschaltet. Der Kondensator dient dazu, den Gleichspannungsanteil abzutrennen und das Plasma elektrisch neutral zu halten. |
||
| ⚫ | |||
| ⚫ | Die Elektronen oszillieren im Gebiet des Plasmas und es kommt vermehrt zu Stößen mit Argonatomen. Dies bewirkt eine hohe Plasmarate, eine Folge davon ist die mögliche Drucksenkung auf 1–20 m[[Torr]] (etwa 10<sup>−1</sup>–10<sup>−2</sup> Pa) bei gleicher Sputterrate. Dies ermöglicht die Herstellung von dünnen Schichten mit einer anderen Gefügestruktur als dies bei höheren Drücken möglich wäre. |
||
Die positiven Ionen bewegen sich durch eine überlagerte negative Offsetspannung am Target in Richtung des Targets und lösen dort wie beim DC-Sputtern durch Stöße Atome bzw. Moleküle aus dem Targetmaterial. Die anschließende Sputterdeposition entspricht denen anderer Sputterverfahren (siehe oben). |
Die positiven Ionen bewegen sich durch eine überlagerte negative Offsetspannung am Target in Richtung des Targets und lösen dort wie beim DC-Sputtern durch Stöße Atome bzw. Moleküle aus dem Targetmaterial. Die anschließende Sputterdeposition entspricht denen anderer Sputterverfahren (siehe oben). |
||
| Zeile 61: | Zeile 66: | ||
* Auch Isolatoren (z. B. [[Aluminiumoxid]] oder [[Bornitrid]]) und Halbleiter werden dadurch sputterbar |
* Auch Isolatoren (z. B. [[Aluminiumoxid]] oder [[Bornitrid]]) und Halbleiter werden dadurch sputterbar |
||
* das Substrat heizt sich weniger auf |
* das Substrat heizt sich weniger auf |
||
* Durch die oszillierenden Elektronen ist die Sputterrate bei gleichem Kammerdruck etwa |
* Durch die oszillierenden Elektronen ist die Sputterrate bei gleichem Kammerdruck etwa 10-mal höher als beim DC-Sputtern. |
||
Nachteile: |
Nachteile: |
||
* Verhältnismäßig niedrige Beschichtungsraten |
* Verhältnismäßig niedrige Beschichtungsraten |
||
* die HF-Erzeugung ist aufwendiger als eine Gleichspannungsquelle |
* die HF-Erzeugung ist aufwendiger als eine Gleichspannungsquelle |
||
* Bei großen Rechteckkathoden ( |
* Bei großen Rechteckkathoden (größer 1 m) können Ungleichmäßigkeiten in der [[Plasmadichte]] (Schichtdickenverteilung) auftreten |
||
Eine Variante des HF-Sputtern ist das sogenannte Bias-Sputtern.<ref>{{Literatur | Autor = Hwaiyu Geng | Titel = Semiconductor Manufacturing Handbook | Verlag = Surendra Kumar | Jahr = 2005 | ISBN = 9780071445597|Seiten=13.14ff}}</ref> Dabei wird der Substrathalter nicht auf Massepotential gehalten, sondern mit einem meist negativem elektrischen Potential (−50 bis −500 V) belegt. Dies hat einen erhöhten Beschuss des Substrates mit Argonionen zur Folge. Durch diesen Beschuss können zum einen lose gebundene Verureinigungen von der Oberfläche gelöst werden, zum anderen bringt es zusätzliche Energie in die abgeschiedene Schicht ein. Durch diesen Rücksputtereffekt ist es möglich, die Schichteigenschaften positiv zu beeinflussen oder die Abscheidung in Gräben zu verbessern.<ref>{{Literatur | Autor = Dietrich Widmann, Hermann Mader, Hans Friedrich | Titel = Technologie Hochintegrierter Schaltungen | Verlag = Gabler Wissenschaftsverlage | Jahr = 1996 | ISBN = 9783540593577 | Seiten =32–33}}</ref> |
|||
==== Magnetronsputtern ==== |
==== Magnetronsputtern ==== |
||
| Zeile 81: | Zeile 88: | ||
==== Reaktives Sputtern ==== |
==== Reaktives Sputtern ==== |
||
Beim reaktiven Sputtern<ref>{{Literatur | Autor = Hari Singh Nalwa | Titel = Handbook of thin film materials: Deposition and processing of thin films | Verlag = Academic Press | Jahr = 2002 | ISBN = 9780125129084 |Seiten =416–419}}</ref> werden dem inerten Arbeitsgas ([[Argon|Ar]]) ein oder mehrere reaktive Gase (z. B. [[Sauerstoff]] oder [[Stickstoff]]) zugesetzt. Die Gase reagieren am Target, in der Vakuumkammer oder am Substrat mit den mit den zerstäubten Schichtatomen und bilden neue Materialien. Die entstandenen Reaktionsprodukte scheiden sich anschließend an der Substratoberfläche ab. Zum Beispiel: |
|||
:<math>\mathrm{4\,Al (Target) + 3\,O_2 \longrightarrow 2\,Al_2O_3 (Schicht)}</math> |
:<math>\mathrm{4\,Al (Target) + 3\,O_2 \longrightarrow 2\,Al_2O_3 (Schicht)}</math> |
||
Das reaktive Sputtern kann mit anderen Varianten wie dem DC-, HF- oder Magnetronsputtern kombiniert werden. Es wird hauptsächlich eingesetzt, um [[Oxide]] (SiO<sub>2</sub>, Al<sub>2</sub>O<sub>3</sub>, ZnO), [[Nitride]] (Si<sub>3</sub>N<sub>4</sub>, TiN, A1N) und [[Oxinitride]] (z .B. SiO<sub>x</sub>N<sub>y</sub>) abzuscheiden. Die Schichteigenschaften lassen beim reaktiven Sputtern unter anderem über den Gasmassenfluss gut beeinflussen. |
|||
Reaktives Sputtern gibt es als DC- und HF-Variante. |
|||
Neben Sauerstoff oder Stickstoff werden auch einfache Moleküle wie [[Wasser]]dampf, [[Amoniak]], [[Schwefelwasserstoff]], [[Methan]] oder [[Tetrafluormethan]] als Reaktionsgas eingesetzt, beispielsweise für [[Cadmiumsulfid]], [[Polytetrafluorethylen]] oder [[Carbide]] wie [[Tantalcarbid]].<ref>vgl. {{Literatur | Autor = Diederik Depla, Stijn Mahieu | Titel = Reactive Sputter Deposition | Verlag = Springer | Jahr = 2008 | ISBN = 9783540766629}}</ref> |
|||
Da die zugesetzten Gase wie das Arbeitsgas im Plasmaraum ionisiert werden, erhöht sich zum einen die [[Reaktivität]] und damit die Reaktionsrate mit dem zerstäubten Targetmaterial, zum anderen werden die Ionen des Reaktionsgases aber auch in Richtung des Target beschleunigt. Beim Auftreffen auf das Target schlagen sie wie die Argonionen aber nicht nur Teilchen aus dem Target, sondern werden zu einem gewissen Anteil auch selbst in das Target eingebaut. Dies führt zu einer Verunreinigung des Target. Ein Problem das sich zeigt, wenn das Target für die Abscheidung anderer Materialkompositionen genutzt werden soll. |
|||
==== Ionenstrahlsputtern ==== |
==== Ionenstrahlsputtern ==== |
||
| Zeile 102: | Zeile 112: | ||
Die Sputterdeposition ist eine der Standardbeschichtungstechniken und findet vielfältige Anwendung in der Industrie. Die für die Beschichtung verwendbaren Materialien bzw. Materialsysteme unterscheiden sich stark durch das eingesetzte Spezialverfahren. Generell ist die Bandbreite an möglichen Materialien aber sehr groß. Mit „klassischen“ (passiven) Sputterdepositionsverfahren werden hauptsächlich Metalle abgeschieden, beispielsweise [[Titan (Element)|Titan]], [[Wolfram]] und [[Nickel]], aber auch Legierungen Nickelaluminium (NiAl) und Nichtmetalle wie [[Silicium]] oder [[Siliciumdioxid]] (SiO<sub>2</sub>) sind möglich. |
Die Sputterdeposition ist eine der Standardbeschichtungstechniken und findet vielfältige Anwendung in der Industrie. Die für die Beschichtung verwendbaren Materialien bzw. Materialsysteme unterscheiden sich stark durch das eingesetzte Spezialverfahren. Generell ist die Bandbreite an möglichen Materialien aber sehr groß. Mit „klassischen“ (passiven) Sputterdepositionsverfahren werden hauptsächlich Metalle abgeschieden, beispielsweise [[Titan (Element)|Titan]], [[Wolfram]] und [[Nickel]], aber auch Legierungen Nickelaluminium (NiAl) und Nichtmetalle wie [[Silicium]] oder [[Siliciumdioxid]] (SiO<sub>2</sub>) sind möglich. |
||
Reaktive Verfahren hingegen ermöglichen durch den Einbau zusätzlicher Komponenten aus dem Gasraum die Abscheidung von Metallverbindungen, beispielsweise Metalloxide wie [[Aluminiumoxid]] (Al<sub>2</sub>O<sub>3</sub>) mit hoher Präzision in der [[Stöchiometrie]] der Schicht. |
Reaktive Verfahren hingegen ermöglichen durch den Einbau zusätzlicher Komponenten aus dem Gasraum die Abscheidung von Metallverbindungen, beispielsweise Metalloxide wie [[Aluminiumoxid]] (Al<sub>2</sub>O<sub>3</sub>) mit hoher Präzision in der [[Stöchiometrie]] der Schicht. |
||
In der Halbleiter- und Mikrosystemtechnik wird das Verfahren vor allem für die Herstellung von dünnen Schichten eingesetzt, beispielsweise Aluminium oder Titannitrid <ref>{{Literatur | Autor = Dietrich Widmann, Hermann Mader, Hans Friedrich | Titel = Technologie Hochintegrierter Schaltungen | Verlag = Gabler Wissenschaftsverlage | Jahr = 1996 | ISBN = 9783540593577}}</ref> |
|||
In der Halbleitertechnologie und Mikrosystemtechnik wird das Verfahren vor allem für die Herstellung von dünnen Schichten eingesetzt. <!--Konkrete Beispiele folgen noch--> |
|||
Aber auch in anderen industriellen Bereichen werden gesputterte Dünnschichten eingesetzt, beispielsweise in der Material- bzw. Oberflächenveredelung (z. B. Spiegel, Autoscheinwerfer, [[Autofelge]]) oder in der Optik als funktionelle Schicht (z. B. Dünnschicht-[[Polarisator]], [[Wärmeschutzglas]]). |
Aber auch in anderen industriellen Bereichen werden gesputterte Dünnschichten eingesetzt, beispielsweise in der Material- bzw. Oberflächenveredelung (z. B. Spiegel, Autoscheinwerfer, [[Autofelge]]) oder in der Optik als funktionelle Schicht (z. B. Dünnschicht-[[Polarisator]], [[Wärmeschutzglas]]). |
||
| Zeile 113: | Zeile 122: | ||
== Literatur == |
== Literatur == |
||
*{{Literatur|Autor=P. J. Martin|Titel=Ion-based methods for optical thin film deposition|Sammelwerk=Journal of Materials Science|Band=21|Nummer=1|Jahr=1986|Seiten=1–25|DOI=10.1007/BF01144693}} |
*{{Literatur|Autor=P. J. Martin|Titel=Ion-based methods for optical thin film deposition|Sammelwerk=Journal of Materials Science|Band=21|Nummer=1|Jahr=1986|Seiten=1–25|DOI=10.1007/BF01144693}} |
||
*Markus Bautsch: ''Rastertunnelmikroskopische Untersuchungen an mit Argon zerstäubten Metallen'', Kapitel 2.4: ''Zerstäubung von Oberflächen durch Teilchenbeschuss'', Unterkapitel: ''Zerstäubungsrate - Abtraggeschwindigkeit - Mikrostrukturerntstehung - Sekundäre Effekte'' |
*Markus Bautsch: ''Rastertunnelmikroskopische Untersuchungen an mit Argon zerstäubten Metallen'', Kapitel 2.4: ''Zerstäubung von Oberflächen durch Teilchenbeschuss'', Unterkapitel: ''Zerstäubungsrate - Abtraggeschwindigkeit - Mikrostrukturerntstehung - Sekundäre Effekte''. Verlag Köster, Berlin 1993, ISBN 3-929937-42-5, S. 18–27. |
||
== Weblinks == |
== Weblinks == |
||
Version vom 3. April 2012, 10:58 Uhr
Das Sputtern (aus dem Englischen to sputter = zerstäuben) – oder auf deutsch, die Kathodenzerstäubung – ist ein physikalischer Vorgang, bei dem Atome aus einem Festkörper (Target) durch Beschuss mit energiereichen Ionen (vorwiegend Edelgasionen) herausgelöst werden und in die Gasphase übergehen.
Angewendet wird dieser Effekt beispielsweise in der Oberflächenphysik als Reinigungsverfahren zur Präparation hochreiner Oberflächen, als Verfahren zur Analyse der chemischen Zusammensetzung von Oberflächen (z. B. SIMS, SNMS) oder als Sputter-Ionenquelle für Teilchenbeschleuniger zum Einsatz. Große technische Bedeutung hat das Verfahren als Teilschritt bei der Sputterdeposition, einer zur Gruppe der PVD-Verfahren gehörenden hochvakuumbasierte Beschichtungstechnik. Hier dient es zum Zerstäuben eines Materials, dass sich anschließend auf einem Substrat niederschlägt und eine feste Schicht bildet. Im Bereich der beschichtungstechnik wird die Sputterdeposition häufig nur als „Sputtern“ bezeichnet.
In Elektronenröhren und Gasentladungsröhren wie Glimmlampen und Nixie-Röhren gehört Sputtern zu den unerwünschten, Lebensdauer-begrenzenden Effekten. Durch das Auftreffen von Ionen auf die Elektroden werden diese in Mitleidenschaft gezogen. Zudem schlägt sich das abgetragene Elektrodenmaterial an der Innenseite des Glaskolbens ab, was dessen Transparenz vermindert.
Grundlagen des Sputterprozesses
Beim Beschuss einer Oberfläche mit Ionen können, abhängig von den verwendeten Ionen und ihrer kinetischen Energie, verschiedene Effekte auftreten:
- Es wird Material von dem bombardierten Target (Kathode) abgetragen. Dies ist das hier beschriebene Sputtern.
- Die Ionen werden in das Targetmaterial eingebaut und gehen dort gegebenenfalls eine chemische Verbindung ein. Dieser Effekt wird dann (reaktive) Ionenimplantation genannt.
- Die Ionen kondensieren auf dem beschossenen Substrat und bilden dort eine Schicht: Ionenstrahldeposition.
Ist ein Materialabtrag beabsichtigt, müssen die Ionen eine gewisse Mindestenergie besitzen. Das auftreffende Ion überträgt seinen Impuls auf Atome des beschossenen Materials, die dann – ähnlich wie beim Billard – in einer Stoßkaskade weitere Kollisionen auslösen. Nach mehreren Kollisionen hat ein Teil der Targetatome einen Impuls, der vom Targetinneren fortweist. Ist ein solches Atom genügend nahe der Oberfläche und hat es eine hinreichend hohe Energie, verlässt es das Target.
Die Sputterausbeute hängt dabei im Wesentlichen von kinetischer Energie und Masse der Ionen sowie von der Bindungsenergie der Oberflächenatome und deren Masse ab. Um ein Atom aus dem Target herauszuschlagen, müssen die Ionen eine materialabhängige Mindestenergie von typ. 30–50 eV aufbringen. Oberhalb dieser Schwelle nimmt die Ausbeute zu. Der zunächst starke Anstieg verflacht aber rasch, da bei hohen Ionenenergien diese Energie immer tiefer im Target deponiert wird und damit kaum noch die Oberfläche erreicht. Das Verhältnis der Massen von Ion und Targetatom bestimmt den möglichen Impulsübertrag. Für leichte Targetatome wird ein Maximum der Ausbeute erzielt, wenn die Masse von Target und Ion annähernd übereinstimmen; mit zunehmender Masse der Targetatome verschiebt sich das Maximum der Ausbeute jedoch zu immer höheren Masseverhältnissen zwischen Ion und Targetatom.
Der Ionenbeschuss erzeugt nicht nur neutrale Atome, sondern auch Sekundärelektronen sowie in geringerem Umfang Sekundärionen und Cluster verschiedener Masse (Sekundärionen-Massenspektrometrie). Die Energieverteilung der gelösten Atome hat ein Maximum bei der halben Oberflächenbindungsenergie bei einigen eV, fällt aber zu hohen Energien nur langsam ab, so dass die mittlere Energie häufig eine Größenordnung darüber liegt. Ausgenutzt wird dieser Effekt in Analysemethoden der Oberflächenphysik und Dünnschichttechnologie sowie zur Herstellung dünner Schichten (Sputterdeposition).
Wird eine atomar dünne Schicht durch Sputtern abgetragen, so kann die Anzahl der nach der Zeit gesputterten Teilchen nach folgender Gleichung abgeschätzt werden:
mit e: Elementarladung, : Anzahl Teilchen auf der Oberfläche (ca. 1015 cm−2), Y: Sputterausbeute (Anzahl der gesputterten Teilchen pro auftreffendes Teilchen), : Primärstrom.
Sputterdeposition
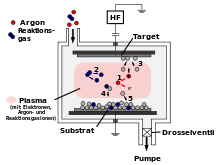
Allgemeines
Bei der Sputterdeposition, auch Sputterbeschichtung genannt, wird in die Nähe des Targets ein Substrat gebracht, so dass die herausgeschlagenen Atome auf diesem kondensieren und eine Schicht bilden können. Dabei muss in der Prozesskammer ein ausreichend geringer Gasdruck vorhanden sein (ein Vakuum), dass die Targetatome das Substrat erreichen ohne mit noch vorhandenen Gasteilchen zusammen zustoßen. Das heißt, die mittlere freie Weglänge der Gasteilchen muss mindestens dem Abstand des Targets zum Substrat entsprechen. Bei einem Abstand von ca. 30 cm sollte der Gasdruck daher nicht größer als ca. 2×10−4 mbar (Hochvakuum) betragen, andernfalls sind schlechtere Schichteigenschaften die Folge.
Als Ionenquelle dient hierbei in den meisten Anwendungen eine Gleichstrom-Gasentladung (DC-Sputtern). Wenn zusätzlich unter dem Target ein Magnet angebracht ist, spricht man von Magnetronzerstäubung. In dieser Konfiguration können alle leitfähigen Materialien deponiert werden. Es tritt keine Entmischung von Legierungen auf, was beispielsweise beim thermischen Verdampfen auftreten kann. Auch ist die Haftung der Schichten meist besser als bei aufgedampften, und es können große Flächen, z. B. Architekturglas, homogen beschichtet werden. Für diese Anwendung werden Magnetron-Kathoden mit einer Länge von 3,5 m eingesetzt. Auch werden auf diese Weise integrierte Schaltkreise auf Wafern metallisiert. Bei diesen Applikationen werden normalerweise möglichst reine Metallschichten gewünscht. Daher werden in diesen Fällen hochreine Edelgase eingesetzt, um eine Oxidation der Schichten zu vermeiden. Dies ist in der Regel Argon.
Die Beschichtung von Architekturverglasungen oder Absorbern bei thermischen Sonnenkollektoren besteht aus Schichtsystemen, bei denen auch transparente und teilabsorbierende Materialien, die häufig nicht oder nicht hinreichend elektrisch leitend sind, zum Einsatz kommen. Hier kann dem Inertgas wie Argon gezielt ein Reaktivgas, meist Stickstoff oder Sauerstoff, hinzugefügt werden, um entsprechende Verbindungen zu deponieren. In diesem Fall spricht man von reaktiven Sputtern.
Andere Nichtleiter, bei denen auch reaktive Sputterdeposition nicht möglich oder praktikabel ist, können meist mit Hochfrequenz- oder Ionenstrahlsputtern deponiert werden; allerdings geht hierbei der Vorteil der großflächigen Homogenität zum großen Teil verloren.
Varianten
Die Sputterdeposition zählt seit Jahrzehnten zu den wichtigsten Beschichtungsverfahren. In dieser Zeit wurden unterschiedliche Varianten entwickelt, mit denen sich die Schichteigenschaften gezielt beeinflussen oder die Bandbreite der abscheidbaren Materialien erhöhen lassen. Nachfolgend werden die wichtigsten Grundformen kurz beschrieben. Dabei ist zu beachten, dass von allen Varianten zusätzlich Mischformen existieren, z. B. dem HF-Magnetronsputtern eine Mischung aus dem Hochfrequenz- und dem Magnetronsputtern.
Die wichtigsten Grundformen sind:
- DC-Sputtern
- HF-Sputtern
- Ionenstrahlsputtern
- Magnetronsputtern
- Reaktives Sputtern
DC-Sputtern
Beim DC-Sputtern wird zwischen Target und dem zu beschichtenden Substrat eine Gleichspannung von einigen hundert Volt angelegt, es wird daher auch Gleichspannungssputtern genannt. Das Target bildet hierbei die negative und das Substrat die positiv geladene Elektrode. Durch Stoßionisation der Atome des eingesetzten Inertgases (z. B. Argon) bildet sich im Gasraum ein Plasma (ein Argon-Niederdruckplasma), dessen Bestandteile negativ geladene Elektronen und positiv geladene Gasionen, wie Ar+, durch die angelegte Gleichspannung in Richtung des Substrats bzw. des Targets beschleunigt werden. Es trifft nun ein dauerhafter Strom aus positiven Ionen auf das Target; daher auch der englischsprachige Name des Verfahrens direct current sputtering, dt. Gleichstrom- bzw. DC-Sputtern. Beim Aufprall auf das Target werden durch Impulsübertrag Teilchen aus dem Target herausgeschlagen, die sich nun weg vom Target in Richtung des Substrates bewegen und sich dort als dünne Schicht niederschlagen (Deposition).
Wesentlicher Nachteil dieses Verfahrens ist, dass diese Variante nur für mit elektrisch leitfähigen Targetmaterialien anwendbar ist. Elektrisch isolierende Materialien würden sich durch die ständig Versorgung mit neuen Ladungsträgern aufladen, damit das Gleichspannungfeld kompensieren und den Sputterprozess behindern. Ähnlich verhält es sich mit dem Substrat, dass sich durch die auftreffenden energiereichen Elektronen nicht nur aufladen könnte sondern sich auch einer hohe Wärmebelastung ausgesetzt ist. Darüber hinaus sind die erreichbaren Sputterraten und damit auch die Beschichtungsraten relativ gering, da in dem eingesetzten Niederdruckplasma nur wenige Argonionen entstehen.
Die zuvor beschriebene Variante mit zwei Elektroden wird auch als DC-Dioden-Sputtern bezeichnet. Darüberhinaus existieren noch weitere Formen wie das DC-Trioden-Sputtern, bei dem das Target als dritte Elektrode außerhalb des Plasmaraums angeordnet wird. Auf diese Weise kann die Plasmaerzeugung und der Sputterprozess entkoppelt werden.
HF-Sputtern
Beim Hochfrequenzsputtern (kurz HF-Sputtern, engl. radio frequency sputtering, RF sputtering) wird statt des elektrischen Gleichfeldes ein hochfrequentes Wechselfeld angelegt (meist mit der freie Funkfrequenz von 13,56 MHz oder Vielfachen davon). Die dafür notwendige Hochfrequenzspannungsquelle wird in Reihe mit einem Kondensator und dem Plasma geschaltet. Der Kondensator dient dazu, den Gleichspannungsanteil abzutrennen und das Plasma elektrisch neutral zu halten.
Durch das Wechselfeld werden die Ionen (meist Argonionen) und die Elektronen abwechselnd in beide Richtungen beschleunigt. Ab einer Frequenz von ungefähr 50 kHz können die Ionen aufgrund ihres deutlich kleineren Ladung-zu-Masse-Verhältnisses dem Wechselfeld nicht mehr folgen. Die Elektronen oszillieren im Gebiet des Plasmas und es kommt vermehrt zu Stößen mit Argonatomen. Dies bewirkt eine hohe Plasmarate, eine Folge davon ist die mögliche Drucksenkung auf 1–20 mTorr (etwa 10−1–10−2 Pa) bei gleicher Sputterrate. Dies ermöglicht die Herstellung von dünnen Schichten mit einer anderen Gefügestruktur als dies bei höheren Drücken möglich wäre. Die positiven Ionen bewegen sich durch eine überlagerte negative Offsetspannung am Target in Richtung des Targets und lösen dort wie beim DC-Sputtern durch Stöße Atome bzw. Moleküle aus dem Targetmaterial. Die anschließende Sputterdeposition entspricht denen anderer Sputterverfahren (siehe oben).
Vorteile:
- Auch Isolatoren (z. B. Aluminiumoxid oder Bornitrid) und Halbleiter werden dadurch sputterbar
- das Substrat heizt sich weniger auf
- Durch die oszillierenden Elektronen ist die Sputterrate bei gleichem Kammerdruck etwa 10-mal höher als beim DC-Sputtern.
Nachteile:
- Verhältnismäßig niedrige Beschichtungsraten
- die HF-Erzeugung ist aufwendiger als eine Gleichspannungsquelle
- Bei großen Rechteckkathoden (größer 1 m) können Ungleichmäßigkeiten in der Plasmadichte (Schichtdickenverteilung) auftreten
Eine Variante des HF-Sputtern ist das sogenannte Bias-Sputtern.[1] Dabei wird der Substrathalter nicht auf Massepotential gehalten, sondern mit einem meist negativem elektrischen Potential (−50 bis −500 V) belegt. Dies hat einen erhöhten Beschuss des Substrates mit Argonionen zur Folge. Durch diesen Beschuss können zum einen lose gebundene Verureinigungen von der Oberfläche gelöst werden, zum anderen bringt es zusätzliche Energie in die abgeschiedene Schicht ein. Durch diesen Rücksputtereffekt ist es möglich, die Schichteigenschaften positiv zu beeinflussen oder die Abscheidung in Gräben zu verbessern.[2]
Magnetronsputtern
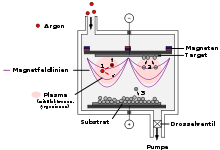
Während bei der einfachen Kathodenzerstäubung lediglich ein elektrisches Feld angelegt wird, ist beim Magnetronsputtern hinter der Kathodenplatte ein zusätzliches Magnetfeld angeordnet. Durch die Überlagerung von elektrischem Feld und magnetischem Feld bewegen sich die Ladungsträger nicht mehr parallel zu den elektrischen Feldlinien, sondern werden auf eine Spiralbahn (genauer Zykloidenbahnen) abgelenkt (siehe Lorentz-Kraft) – sie kreisen nun über der Target-Oberfläche. Dadurch wird deren Weg verlängert und die Zahl der Stöße pro Elektron erhöht sich. Die Elektronendichte ist dabei an der Stelle am höchsten, wo das Magnetfeld parallel zur Target-Oberfläche liegt. Dies bewirkt eine höhere Ionisation in diesem Bereich. Da die Ionen aufgrund ihrer Masse kaum vom Magnetfeld abgelenkt werden, findet der größte Sputterabtrag auf dem Target unmittelbar im Bereich darunter statt. Auf dem Target bilden sich dort die für das Magnetronsputtern typischen Erosionsgräben.
Das effektiv höhere Ionisierungsvermögen der Elektronen führt zu einer Erhöhung der Edelgasionenzahl und somit auch der Sputterrate. Da mehr Target-Material zerstäubt wird, führt dies zu deutlich höheren Beschichtungsraten bei gleichem Prozessdruck. Da das Schichtwachstum und somit die Schichteigenschaften neben der Temperatur vor allem vom Prozessdruck abhängig ist, kann man bei gleichen Wachstumsraten den Prozessdruck um bis zu einhundert Mal geringer als beim konventionellen Kathodenzerstäuben ansetzen. Das führt zu weniger Streuung des Materials auf dem Weg zum Substrat und zu einer dichteren (weniger porösen) Schicht.
Magnetronsputtern ist in der Mikroelektronik das meist eingesetzte Verfahren zum Erzeugen von Metallschichten.
Das Hochenergieimpulsmagnetronsputtern[3] (high-power impulse magnetron sputtering, HiPIMS) ist ein weiterentwickeltes Verfahren, das die Wirkung von pulsartigen Entladungen () mit Leistungen größer 1 MW nutzt, um einen deutlich erhöhtem Ionisierungsgrad zu erreichen. Der hohe Grad der Ionisierung kann über einen geänderten Wachstumsmechanismus die Eigenschaften der aufwachsenden Schicht erheblich verändern, und führt beispielsweise zu einer höheren Haftfestigkeit.
Reaktives Sputtern
Beim reaktiven Sputtern[4] werden dem inerten Arbeitsgas (Ar) ein oder mehrere reaktive Gase (z. B. Sauerstoff oder Stickstoff) zugesetzt. Die Gase reagieren am Target, in der Vakuumkammer oder am Substrat mit den mit den zerstäubten Schichtatomen und bilden neue Materialien. Die entstandenen Reaktionsprodukte scheiden sich anschließend an der Substratoberfläche ab. Zum Beispiel:
Das reaktive Sputtern kann mit anderen Varianten wie dem DC-, HF- oder Magnetronsputtern kombiniert werden. Es wird hauptsächlich eingesetzt, um Oxide (SiO2, Al2O3, ZnO), Nitride (Si3N4, TiN, A1N) und Oxinitride (z .B. SiOxNy) abzuscheiden. Die Schichteigenschaften lassen beim reaktiven Sputtern unter anderem über den Gasmassenfluss gut beeinflussen. Neben Sauerstoff oder Stickstoff werden auch einfache Moleküle wie Wasserdampf, Amoniak, Schwefelwasserstoff, Methan oder Tetrafluormethan als Reaktionsgas eingesetzt, beispielsweise für Cadmiumsulfid, Polytetrafluorethylen oder Carbide wie Tantalcarbid.[5]
Da die zugesetzten Gase wie das Arbeitsgas im Plasmaraum ionisiert werden, erhöht sich zum einen die Reaktivität und damit die Reaktionsrate mit dem zerstäubten Targetmaterial, zum anderen werden die Ionen des Reaktionsgases aber auch in Richtung des Target beschleunigt. Beim Auftreffen auf das Target schlagen sie wie die Argonionen aber nicht nur Teilchen aus dem Target, sondern werden zu einem gewissen Anteil auch selbst in das Target eingebaut. Dies führt zu einer Verunreinigung des Target. Ein Problem das sich zeigt, wenn das Target für die Abscheidung anderer Materialkompositionen genutzt werden soll.
Ionenstrahlsputtern
Beim Ionenstrahlsputtern (engl. ion beam sputter deposition, IBSD) wird aus einer Ionenquelle ein Strahl von Edelgas-Sputterionen (Ar, Kr, Xe) auf das Target geleitet. Der auftreffende Ionenstrahl wird mithilfe eines gerichteten Ionenstrahls zerstäubt. Dabei bietet das Ionenstrahlsputtern die Möglichkeit, die Teilchenenergien gezielt und energetisch schmalbandig einzustellen – die kinetische Energien der schichtbildenden Teilchen ist dabei höher als bei alternativen Vakuumbeschichtungstechniken wie Verdampfung oder Magnetronsputtern. Dadurch ist es möglich, eine gleichmäßigere Kondensation des Materialdampfes zu erreichen und so u. a. dichte, glatte und defektfreie Schichten zu erzeugen.
Durch einen sogenannten Assist-Ionenstrahl ist es weiterhin möglich die wachsende Schicht zu beeinflussen oder einen zusätzlichen Reaktivprozess zu initiieren (siehe Ionenstrahlgestützte Deposition).[6]
Atomstrahlsputtern
Auch isolierende Materialien können zur Vermeidung von elektrostatischen Aufladungen mit Hilfe von Atomstrahlen gesputtert werden, die zum Beispiel mit einem Kapillaritron erzeugt werden können.
Anwendung
Der Sputtereffekt wird in der Materialbearbeitung und Analytik für die Reinigung von Werkstoffen und Proben eingesetzt. So kann durch eine Sputterreinigung die Oberfläche von kleinen Partikeln und organischen Verschmutzungen befreit werden, so dass ein nachfolgender Beschichtungsprozess reproduzierbarer erfolgen kann. Ähnliches gilt für die Reinigung von Proben bei oberflächensensitiven Messtechniken, beispielsweise bei der Photoelektronenspektroskopie (UPS, XPS, usw.) durch kurzen Beschuss durch Argonionen. Der Sputtereffekt kann aber auch dazu dienen, um Informationen aus tieferen Bereichen zu erhalten. So kann bei Photoelektronenspektroskopie und Sekundärionen-Massenspektrometrie (SIMS) durch abwechselndes bzw. gleichzeitiges Sputtern und Messen ein Tiefenprofil von Schichtsystemen bestimmt werden – dabei müssen jedoch Effekte wie Vorzugssputtern (unterschiedliche Sputterraten für verschiedenschwere Atome) beachtet werden.
Die Sputterdeposition ist eine der Standardbeschichtungstechniken und findet vielfältige Anwendung in der Industrie. Die für die Beschichtung verwendbaren Materialien bzw. Materialsysteme unterscheiden sich stark durch das eingesetzte Spezialverfahren. Generell ist die Bandbreite an möglichen Materialien aber sehr groß. Mit „klassischen“ (passiven) Sputterdepositionsverfahren werden hauptsächlich Metalle abgeschieden, beispielsweise Titan, Wolfram und Nickel, aber auch Legierungen Nickelaluminium (NiAl) und Nichtmetalle wie Silicium oder Siliciumdioxid (SiO2) sind möglich. Reaktive Verfahren hingegen ermöglichen durch den Einbau zusätzlicher Komponenten aus dem Gasraum die Abscheidung von Metallverbindungen, beispielsweise Metalloxide wie Aluminiumoxid (Al2O3) mit hoher Präzision in der Stöchiometrie der Schicht. In der Halbleiter- und Mikrosystemtechnik wird das Verfahren vor allem für die Herstellung von dünnen Schichten eingesetzt, beispielsweise Aluminium oder Titannitrid [7] Aber auch in anderen industriellen Bereichen werden gesputterte Dünnschichten eingesetzt, beispielsweise in der Material- bzw. Oberflächenveredelung (z. B. Spiegel, Autoscheinwerfer, Autofelge) oder in der Optik als funktionelle Schicht (z. B. Dünnschicht-Polarisator, Wärmeschutzglas).
Nachteile
Generell ist bei der Reinigung der Oberfläche bei empfindlichen Materialien (z. B. Graphit-Einkristallen) durch Sputtern zu bedenken, dass durch das Sputtern die Kristallstruktur (teilweise) zerstört wird. Bei zu starkem Sputtern, also bei zu hoher Energie der Ionen, besteht zusätzlich die Gefahr, dass die noch nicht abgetragenen Schmutzatome in die Oberfläche eingebracht werden (engl. knock-on effect).[8]
Literatur
- P. J. Martin: Ion-based methods for optical thin film deposition. In: Journal of Materials Science. Band 21, Nr. 1, 1986, S. 1–25, doi:10.1007/BF01144693.
- Markus Bautsch: Rastertunnelmikroskopische Untersuchungen an mit Argon zerstäubten Metallen, Kapitel 2.4: Zerstäubung von Oberflächen durch Teilchenbeschuss, Unterkapitel: Zerstäubungsrate - Abtraggeschwindigkeit - Mikrostrukturerntstehung - Sekundäre Effekte. Verlag Köster, Berlin 1993, ISBN 3-929937-42-5, S. 18–27.
Weblinks
- Vorlesungsskript Dünnschichttechnik - Institut für Mikrosystemtechnik, Freiburg (PDF-Datei; 2,90 MB)
Einzelnachweise
- ↑ Hwaiyu Geng: Semiconductor Manufacturing Handbook. Surendra Kumar, 2005, ISBN 978-0-07-144559-7, S. 13.14 ff.
- ↑ Dietrich Widmann, Hermann Mader, Hans Friedrich: Technologie Hochintegrierter Schaltungen. Gabler Wissenschaftsverlage, 1996, ISBN 978-3-540-59357-7, S. 32–33.
- ↑ Wolfgang Bergmann: Werkstofftechnik 2: Werkstoffherstellung- Werkstoffverarbeitung- Werkstoffanwendung. Hanser Verlag, 2009, ISBN 978-3-446-41711-3, S. 215.
- ↑ Hari Singh Nalwa: Handbook of thin film materials: Deposition and processing of thin films. Academic Press, 2002, ISBN 978-0-12-512908-4, S. 416–419.
- ↑ vgl. Diederik Depla, Stijn Mahieu: Reactive Sputter Deposition. Springer, 2008, ISBN 978-3-540-76662-9.
- ↑ Peter Gawlitza, Stefan Braun, Andreas Leson, Sebastian Lipfert, Matthias Nestler: Herstellung von Präzisionsschichten mittels Ionenstrahlsputtern. In: Vakuum in Forschung und Praxis. Band 19, Nr. 2, 2007, S. 37–43, doi:10.1002/vipr.200700310.
- ↑ Dietrich Widmann, Hermann Mader, Hans Friedrich: Technologie Hochintegrierter Schaltungen. Gabler Wissenschaftsverlage, 1996, ISBN 978-3-540-59357-7.
- ↑ Diederik Depla, Stijn Mahieu: Reactive Sputter Deposition. Springer, 2008, ISBN 978-3-540-76662-9, S. 172.





